삼성, 업계 최초 3차원 12단 기술 개발…“반도체 패키징 초격차”
업계 최대 용량 24GB HBM 양산 예정
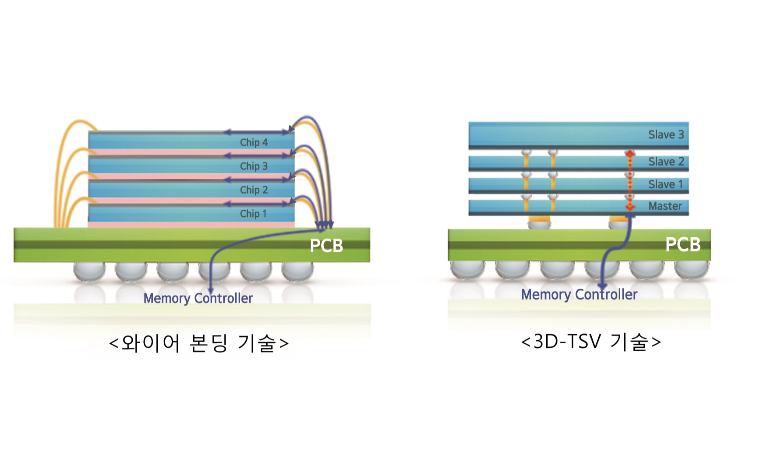
삼성전자는 업계 최초로 D램 12개를 쌓아 수직으로 연결하는 반도체 패키징 기술을 개발하며 반도체 패키징 기술에서 초격차 전략을 펼치고 있다. 삼성전자는 업계 최초로 ‘12단 3D-TSV’(3차원 실리콘 관통전극) 기술 개발에 성공했다고 7일 밝혔다.
이 기술은 와이어를 이용해 칩을 연결하는 기존 방식(와이어 본딩)과는 달리 반도체 칩 상단과 하단에 머리카락 굵기의 20분의 1 수준에 불과한 미세한 전자 이동통로 6만개를 만들어 연결하는 방식이다. 종이(100㎛)의 절반 이하 두께로 가공한 D램 칩 12개를 쌓아 수직으로 연결하는 고도의 정밀성이 필요하기 때문에 반도체 패키징 기술 가운데 가장 어려운 것으로 평가된다. 특히 ‘와이어 본딩’ 방식보다 칩 사이에 신호를 주고받는 시간이 짧아져 속도와 소비전력을 획기적으로 개선하는 장점이 있다.
이번 기술 개발에 따라 기존 8단 적층 제품(HBM2)과 같은 패키지 두께(720㎛)를 유지하면서도 12개의 D램 칩을 적층할 수 있게 돼 고객사들은 별도의 시스템 디자인 변경 없이도 고성능의 차세대 고용량 제품을 출시할 수 있을 것이라고 회사측은 덧붙였다. 또 고대역폭 메모리에 이 기술을 적용할 경우 기존 8단에서 12단으로 높임으로써 용량도 1.5배 늘릴 수 있다. 이 기술에 최신 16기가비트(Gb) D램 칩을 적용하면 업계 최대 용량인 24기가바이트(GB)급 고대역폭 메모리(HBM) 제품도 구현할 수 있다. 이는 현재 주력 제품으로 양산 중인 8단 8GB 제품보다 용량이 3배 수준이다.
삼성전자는 고객 수요에 따라 ‘12단 3D-TSV’기술을 적용한 업계 최대 용량의 24GB급 고용량 HBM 제품의 양산에 돌입할 예정이라고 밝혔다./김혜영기자jjss1234567@sedaily.com
[ⓒ 서울경제TV(www.sentv.co.kr), 무단 전재 및 재배포 금지]

관련뉴스
- LH, 주한미군과 호국보훈의 달 맞아 집수리
- 포스코인터, K-상사 넘어 글로벌 종합사업회사 변신
- 오세철 VS 이한우, 승자는?…압구정 2구역서 ‘리턴매치’
- LG디스플레이, ‘흑자전환’ 배수진…OLED에 1.2兆 투자
- “남매 갈등, 부자 싸움으로”…콜마 윤동한, 주식반환청구 소송
- 네이버 ‘정보 유출’ 해킹 아니라지만…의문 여전
- 한화엔진, 준법·윤리경영 강화…‘컴플라이언스 경영’ 선포
- 대우건설, 개포우성7차 입찰 보증금 150억 납부
- 오아시스마켓 “티몬 인수, 채권자-법원 결정에 전적으로 따를 것”
- HS효성첨단소재, 태국 타타스틸과 친환경 원재료 구매 협약
주요뉴스
오늘의 날씨
마포구 상암동℃
강수확률 %
기획/취재
주간 TOP뉴스
- 1장수군, 2025 상반기 직원 이·퇴임식 개최
- 2임실군, 극한 폭염 대비 온열질환 예방 기술 시범 사업 성공적 추진
- 3'순창 강천산' 야간 개장 시작…11월 8일까지
- 4서부지방산림청, 산사태 피해 복구 사업지 '현장 점검'
- 5남원 쌍교동성당, 남원시노인복지관에 1000만 원 기부…어르신 복지 증진 앞장
- 6남원시, 신관사또 부임행차 상반기 공연 성황리 종료
- 7의왕시 , '치매상담, 큐알 코드로' 간편 신청
- 8양주시, 주취자 대응 ‘원스톱’ 체계 구축..."전국 최초"
- 9병무청, 내년 입영하는 육군 기술행정병 일괄 모집 실시
- 10경상북도교육청정보센터 "학교 누리집, 더 똑똑해진다"
































댓글
(0)